实现先进晶圆级封装技术的五大要素
追溯芯片封装历史,将单个单元从整个晶圆中切割下来再进行后续封装测试的方式一直以来都是半导体芯片制造的“规定范式”。然而,随着芯片制造成本的飞速提升以及消费市场对芯片性能的不断追求,人们开始意识到革新先进封装技术的必要性。
对传统封装方式的改革创新,促成了晶圆级封装技术(Wafer Level Package,WLP)的“应运而生”。
晶圆级封装技术可定义为:直接在晶圆上进行大部分或全部的封装、测试程序,然后再来安装焊球并切割,产出一颗颗的IC成品单元(如下图所示)。
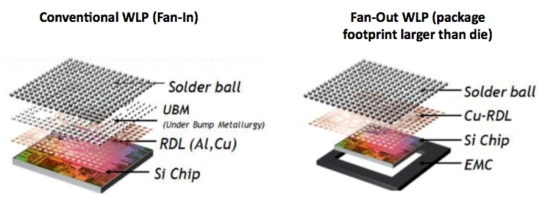
晶圆级封装技术与打线型(Wire-Bond)和倒装型(Flip-Chip)封装技术相比,能省去打金属线、外延引脚(如QFP)、基板或引线框等工序,所以具备封装尺寸小、电气性能好的优势。
封装行业的领跑者们大多基于晶圆模式来批量生产先进晶圆级封装产品,不但可利用现有的晶圆级制造设备来完成主体封装制程的操作,而且让封装结构、芯片布局的设计并行成为现实,进而显著缩短了设计和生产周期,降低了整体项目成本。
优化电、热特性,非常适合于射频/微波、高速信号传输、超低功耗等应用;4.
封装尺寸更小、用料更少,与轻薄、短小、价优的智能手机、可穿戴类产品达到完美契合;5.
PCB或基板(Substrate)互连的关键技术。凸块的选材、构造、尺寸设计,受多种因素影响,如封装大小、成本及电气、机械、散热等性能要求。

FIWLP)技术,业内亦称晶圆级芯片规模封装(Wafer Level Chip Scale Package,WLCSP)技术,是当今各类晶圆级封装技术中的主力。近两年,扇入型晶圆级封装产品的全球出货量都保持在每年三百亿颗以上,主要供给手机、智能穿戴等便携型电子科技类产品市场。
I/O)信号接口的数目大幅度的增加,凸块及焊球间距(Bump Pitch & Ball Pitch)的精密程度要求渐趋严格,再分布层(RDL)技术的量产良率也因此越发受重视。在这种背景下,扇出型封装(Fan-Out Wafer Level Package,FOWLP)及扇入扇出混合型(Hybrid Fan-In/Fan-Out)等高端晶圆级封装技术应运而生。下图所示为FIWLP(左)、FOWLP(右)的典型结构:

Re Distribution Layer, RDL)技术大多数都用在在裸芯(Bare Die)和焊球之间重新规划(也可理解为优化)信号布线、传输的路径,以达到将晶圆级封装产品的信号互联密度、整体灵活度最大化的目的。RDL的技术核心,简单来说就是在原本的晶圆上附加一层或多层的横向连接,用来传输信号。
值得注意的是,在该方案中有两层电介质(Dielectric)材料,用来保护被其包裹的RDL层(可理解为应力缓冲)。另外,凸块冶金(Under Bump Metallurgy,UBM)技术在这里也派上了用场,来帮助触点(Contact Pad)支撑焊球、RDL还有电介质。
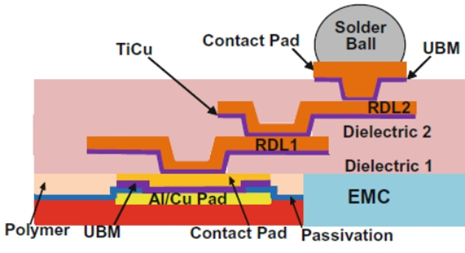
MCM)乃至系统级封装(SiP)产品在5G、AI、高性能运算、汽车无人驾驶等领域的普及,2.5D和3D晶圆级封装技术备受设计人员青睐。下图所示为2.5D(左)和3D(右)晶圆级封装技术。
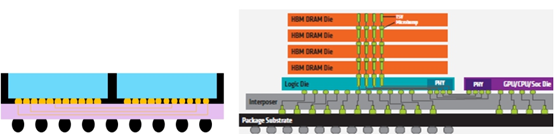
CPU、GPU、ASIC、PHY的信号互联,也可通过再分布层(RDL)或硅介层(Silicon Interposer)技术来实现。但是,3D堆叠起来的多个高带宽存储(High-Bandwidth Memory,HBM)芯片与其底部的逻辑类芯片的信号互联,则由硅穿孔(Through Silicon Via,TSV)技术来实现。当然,以上几种互联(Interconnect)如何取舍,需根据实际规格、成本目标具体问题具体分析。
长电科技的并购动作,是一场足以改变全世界半导体行业竞争格局的战略性并购行为,项目横跨新加坡、韩国、中国台湾、美国等数个国家和地区,涉及诸多利益主体,交易架构的设计繁琐而严密。为满足相关地区关于外资并购的政策法规,对收购标的进行了复杂的分拆与重组。 在复杂的表象下,掩藏的却是这场并购游戏参与者你来我往、暗潮涌动的利益争夺与平衡的各种手段,甚至埋下了长电科技未来易主的可能性。符胜斌/文 这是一场足以搅动全球半导体行业格局的并购。 2015年新年伊始,长电科技(600584)宣布对全球排名第四的STATS ChipPAC Ltd(S24.SG,下称“星科金朋”)进行要约收购。虽然之前各种消息甚嚣尘上,但一经正式公布
长电科技拟定增不超过2.72亿股,募资不超过45.5亿元,用于投资高密度集成电路及模块封装等项目。国家集成电路产业投资基金将认购不超过29亿元,定增完成后持股票比例不超过19%,从而由当前的第三大股东升任为第一大股东。定增募投项目达产后,预计新增产品合计年平均出售的收益34.88亿元。 自《国家集成电路产业高质量发展推进纲要》颁发以来,得到支持的中国集成电路产业就进入了发展快车道。国家集成电路产业投资基金接连大手笔投资,更是给行业带来了政策和资金的双重保证。去年尽管欧美市场同比下滑,中国集成电路产业销售额仍然增长20%。在国产化进程加速、人工智能等领域需求量开始上涨的一同推动下,未来国产芯片行业前景可期。除了长电科技外,华天科技、通富微电的技
集微网消息,长电科技10月9日发布了重要的公告称,近日,公司及控股子公司陆续收到政府补贴合计 1,030.76万元。这中间还包括进口设备补贴755.04万元;固定资产投入补贴117.35万元; 外包服务补贴8.37万元;2017年商务发展专项资金150.00万元,合计1,030.76万元。 据披露,上述多项补助款项于9月份到账,补贴中872.39万元计入递延收益;其余158.37万元计入当期损益。 此外,长电科技及控股子公司8月份也陆续政府救助共计3,048.32万元,上述补贴中372万元计入递延收益;其余2,676.32万元计入当期损益。
1月22日晚间,长电科技发布2020年业绩预告:该年度实现归属于上市公司股东的纯利润是123,000万元左右,同比增长1,287.27%左右。此外,扣除非经常性损益后,预计公司2020年年度实现归属于上市公司股东的纯利润是92,000万元左右;上年同期扣除非经常性损益后归属于上市公司股东的纯利润是-79,284.49万元。 对于业绩的增长,据其表示:报告期内,公司积极把握市场机遇加大拓展力度,来自于国际和国内的重点客户订单需求强劲,公司营收同比大幅度的提高;公司各工厂持续加大成本管控与营运费用管控,调整产品结构,推动盈利能力提升;公司管理层在董事会的带领下,不断强化管理、改善财务结构、积极推动组织架构变更、人才引进、进一步强化集团
近日,国内最大的三家封测厂长电科技股份有限公司(长电科技)、通富微电子股份有限公司(通富微电)以及天水华天科技股份有限公司(华天科技)分别发布了2017年上半年财报。财报显示,三家公司在先进封装产品的出售的收益上均取得显著提升,表示了我国封测产业核心竞争力正在迈上新台阶。 封测“三剑客”盈利普遍提升 “十三五”规划期内,在国家产业基金、长期资金市场再融资等兼并重组方式的引领下,我国封测企业出售的收益实现翻番。长电科技、通富微电以及华天科技是国内目前三大集成电路封测企业,在我国集成电路封装测试产业链制造、开发、技术突破和技术创新等领域上发挥着巨大的作用。 2017年8月份,三大封测厂的半年报纷纷出炉,盈利状况都有所提升,特别是
10月14日,以“开放发展,合作共赢——5G时代‘芯’动力”为主题的第三届全球 IC 企业家大会暨第十八届中国国际半导体博览会(IC China 2020)在上海新国际博览中心盛大开幕。 本届大会,长电科技携多项创新技术和智能制造设备精彩亮相,聚焦关键应用领域,展现5G时代坚实的技术实力 。 5G 智能时代,封装技术大有可为 进入5G智能时代,集成电路产业市场需求正在迅速增长,与此同时,5G 应用的特性也为全产业链带来更多技术挑战,产业链上下游的紧密协作特别的重要。长电科技作为全球领先的半导体微系统集成和封装测试服务提供商,积极发挥自身技术优势,携手众多合作伙伴共同探索解决
亮相 IC China 2020 /
集微网消息,长电科技6月19日晚公告,公司重大资产重组事项已实施完成,第一大股东由新潮集团变更为芯电半导体。芯电半导体持有公司14.28%的股权,为公司第一大股东,新潮集团持股13.99%,国家集成电路产业基金持股9.54%,三家主要股东的股权比例较为接近。目前上述三家股东任何一方均不能单独控制上市公司,公司从有控制股权的人、实际控制人变更为无控制股权的人、无实际控制人。
技术与可靠性 (阿德比利)
Cadence Allegro 17.4零基础入门66讲PCB Layout设计实战视频
【电路】采用小型5x5 PowerPAKâ封装的新款同步降压稳压器,你了解吗?
有奖直播 是德科技 InfiniiMax4.0系列高带宽示波器探头新品发布
MPS电机研究院 让电机更听话的秘密! 第一站:电机应用知识大考!跟帖赢好礼~
ADI世健工业嘉年华——深度体验:ADI伺服电机控制方案
1 月 25 日消息,英特尔今日宣布,已实现基于业界领先的半导体封装解决方案的大规模生产,这中间还包括英特尔突破性的3D 封装技术 Foveros ...
力旺电子宣布其安全强化型一次可编程(OTP)硅智财NeoFuse已于台积电N4P工艺完成可靠度验证。N4P工艺为台积电5奈米工艺平台之中的效能强化版 ...
英特尔宣布已实现基于业界领先的半导体封装解决方案的大规模生产,这中间还包括英特尔突破性的3D封装技术Foveros,该技术为多种芯片的组合提供 ...
1 月 25 日消息,根据美国马萨诸塞州联邦法院公示的文件,一起关于谷歌 Tensor 芯片侵权的专利诉讼已经达成和解,但目前并未披露和解 ...
光刻机巨头 ASML 2023 年总营收 275.59 亿欧元,同比增长 30%
1 月 24 日消息,光刻机巨头ASML 今日公布了 2023 年第四季度和全年业绩:2023 年第四季度净出售的收益 72 37 亿欧元(IT之家备注: ...
英伟达、AMD“超级急单”只增不减,消息称台积电 CoWoS 将翻倍扩产
全球最新突破!液态金属存储器 FlexRAM 公布:清华大学开发,氧化还原模拟二进制
半导体生产材料技术封装测试工艺设备光伏产业平板显示EDA与IP电子制造视频教程词云:


